本文摘自太平洋电脑网,原文链接:https://news.pconline.com.cn/1468/14684804.html,侵删。
三星宣布推出了全新 2.5D 封装解决方案 H-Cube (Hybrid Substrate Cube,混合基板封装),专用于需要高性能和大面积封装技术的高性能计算(HPC)、人工智能(AI)、数据中心和网络产品等领域。

三星表示,2.5D 封装技术通过硅中介层把逻辑芯片和高带宽内存芯片集成在方寸之间。三星 H-Cube 封装解决方案通过 整合两种具有不同特点的基板 ,包括精细化的 ABF(Ajinomoto Build-up Film,味之素堆积膜)基板以及 HDI(High Density Interconnection,高密度互连)基板,可以进一步实现更大的 2.5D 封装。
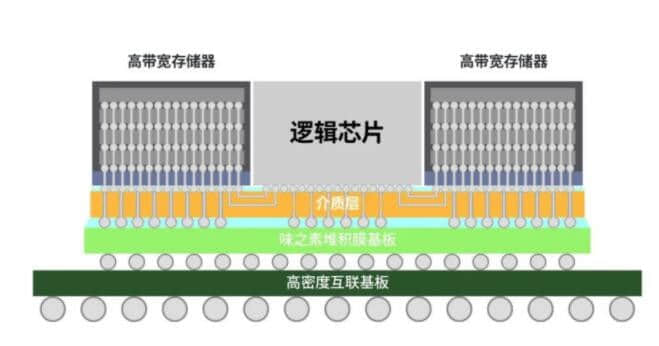
特别是在集成 6 个或以上的 HBM 的情况下,制造大面积 ABF 基板的难度剧增,导致生产效率降低。三星称通过采用在高端 ABF 基板上叠加大面积的 HDI 基板的结构,很好解决了这一难题。“通过将连接芯片和基板的焊锡球的间距缩短 35%,可以缩小 ABF 基板的尺寸,同时在 ABF 基板下添加 HDI 基板以确保与系统板的连接。”
据介绍,通过三星专有的信号/电源完整性分析,在集成多个逻辑芯片和 HBM 的情况下,H-Cube 也能稳定供电和传输信号,而减少损耗或失真。
相关阅读 >>
浪潮b5g战略重磅发布,聚焦数字化转型最后一公里加速5g与行业深度融合
苹果 apple card 新增储蓄账户功能,自动帮用户存钱
lg新能源将更换ceo 新ceo曾在lg集团多家公司担任高管
更多相关阅读请进入《新闻资讯》频道 >>




