本文摘自太平洋电脑网,原文链接:https://news.pconline.com.cn/1468/14685806.html,侵删。
在发布的新闻稿中, 三星电子宣布了新的 2.5D 封装解决方案 H-Cube(Hybrid Substrate Cube,混合基板封装) ,将专门用于需要高性能和大面积封装技术的 HPC、AI、数据中心和网络产品的半导体。
三星电子高级副总裁兼代工市场战略团队负责人 Moonsoo Kang 表示:“H-Cube 解决方案是与三星电机(SEMCO)、Amkor Technology 共同开发的,适用于需要集成大量硅片的高性能半导体。通过扩大和丰富代工生态系统,我们将提供各种封装解决方案,在客户面临的挑战中寻找突破口”。
Amkor Technology 全球研发中心高级副总裁 JinYoung Kim 表示:“在当今系统集成和衬底供应受限的环境下,Samsung Foundry 和 Amkor Technology 成功地共同开发了 H-Cube,以克服这些挑战。这项开发降低了 HPC/AI 市场的准入门槛,显示了代工厂和外包半导体组装和测试(OSAT)公司之间的成功合作和伙伴关系”。
2.5D 封装技术,通过硅中介层把逻辑芯片和高带宽内存芯片集成于方寸之间。三星H-CubeTM封装解决方案,通过整合两种具有不同特点的基板:精细化的ABF(Ajinomoto Build-up Film,味之素堆积膜)基板,以及HDI(High Density Interconnection,高密度互连)基板,可以进一步实现更大的2.5D封装。
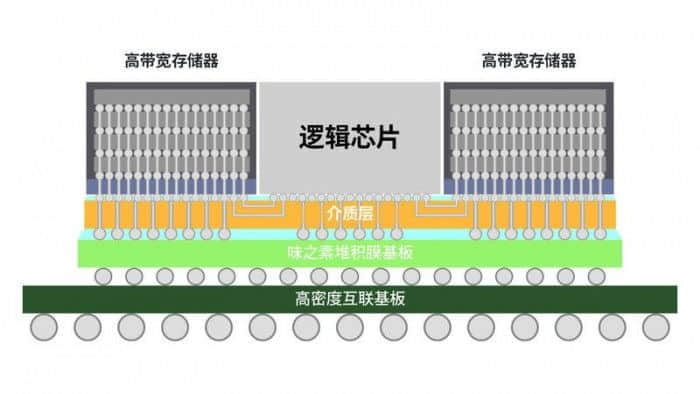
特别是在集成6个或以上的HBM的情况下,制造大面积ABF基板的难度剧增,导致生产效率降低。我们通过采用在高端ABF基板上叠加大面积的HDI基板的结构,很好解决了这一难题。通过将连接芯片和基板的焊锡球的间距缩短35%,可以缩小ABF基板的尺寸,同时在ABF基板下添加HDI基板以确保与系统板的连接。
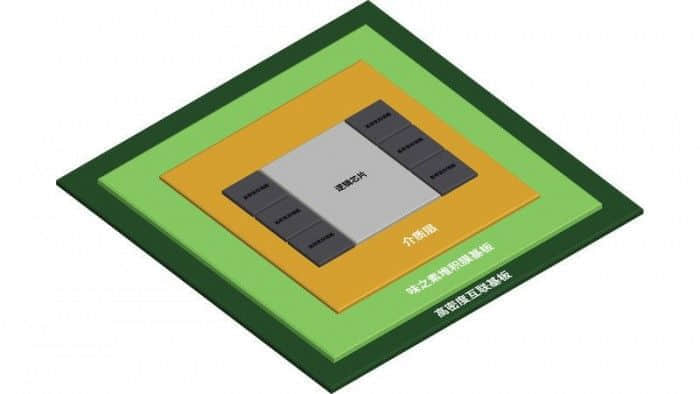
通过将电连接芯片和基板的焊球间距比传统的焊球间距减少35%,细间距基板的尺寸可以最小化,同时在细间距基板下增加HDI基板(模块PCB)以确保与系统板的连接。此外,为了提高H-Cube解决方案的可靠性,三星应用了其专有的信号/电源完整性分析技术,在堆叠多个逻辑芯片和HBM时,可以稳定地提供电源,同时最大限度地减少信号损失或失真。
相关阅读 >>
redmik50天玑9000版配备三星2k直屏,号称史上最贵
李宇浩:工程师、七家上市企业高管和努力「犯错」的机器人「西西弗斯」
佳兆业k-hr系统正式上线 数字赋能人力资源激发内在创新活力
暴雪游戏高校主持人大赛火爆报名中 成为“高校星探长”得d.va可爱音响
更多相关阅读请进入《新闻资讯》频道 >>




